 |
(495)510-98-15
|
|
Меню
|
Главная » Производство комплектующих для высокотехнологичных процессов 1 2 3 4 5 6 7 8 9 10 11 [ 12 ] 13 14 15 16 17 18 19 20 21 22 23 24 25 26 27 28 29 30 31 32 33 34 35 36 37 38 39 40 41 42 43 44 45 46 47 48 49 50 51 52 53 54 Ионной имплантацией получают элементы ИС, которые трудно или даже невозможно изготовить обычной диффузией. Так, резисторы, созданные диффузией, имеют удельное поверхностное сопротивление порядка сотен Ом/кв. и меньше. Высокоомный резистор с удельным поверхностным сопротивлением до 104. ..105 Ом/кв. может быть создан имплантацией ионов в кремний через защитную маску, создающую его конфигурацию. При изготовлении резисторов с электронной электропроводностью (п-типа) в кремний внедряют ионы бора, а с дырочной электропроводностью (р-ти-па) - ионы фосфора. При изготовлении лавинопролетного диода необходимо создавать неглубокий и достаточно резкий р-п-переход. Ионной имплантацией можно получить толщину легированного слоя 0,2 мкм. При производстве МОП-транзисторов с индуцированным каналом диффузионной технологией не удается точно совместить затвор и канал, имплантация же позволяет обеспечить самосовмещение затвора и канала и избежать появления паразитной емкости, снижающей рабочую частоту ИС. Имплантация успешно используется также для снижения порогового напряжения МОП-транзисторов за счет внедрения в область канала через окисел (до нанесения затвора) соответствующих ионов. При создании биполярного транзистора с помощью имплантации можно получить базу после эмиттера, избежав тем са\ мым вытеснения базовой примеси эмиттерной, что может происд ходить при диффузионной технологии. Для получения, формирования и ускорения до необходимых энергий ионных пучков легирующих веществ, а также для размещения обрабатываемых подложек используются ионно-лучевые установки. У нас в стране созданы высокопроизводительные промышленные установки ионной имплантации, различающиеся по конструкции и компоновке отдельных систем, по типу ионных источников и приемных камер, по значениям генерируемого ионного тока, энергиям ионов и дозам имплантируемой примеси. Установки ионной имплантации применяются в производстве БИС, СБИС и/ СВЧ полупроводниковых приборов с размерами элементов 1,5../. .. .2 мкм и менее, повышенной концентрацией носителей зарядов. При этом создаются предпосылки для уменьшения контакта оператора с пластинами. В зависимости от требуемой дозы легирования (количества ионов внедряемого вещества, ударяющегося о единицу поверхности подложки) и энергии ионов разработано несколько типов установок ионной имплантации: больших, средних и малых доз, сильно- и слаботочных, высокоэнергетических. Современные установки позволяют получать дозу легирования от 1010 до 1017 ион/см2, энергия ионов может достигать значений от 30 кэВ до 1 МэВ при токах от 1 мкА до 20 мА. Установки ионной имплантации содержат ионный источник,  Рис. 5.1. Установка Везувий-8 экстрагирующую и фокусирующую оптику, устройства ускорения, сепарации по массам и сканирования ионного пучка, приемную камеру, вакуумную систему, источники питания, устройства контроля и управления технологическим процессом. На рис. 5.1 изображена схема установки ионной имплантации Везувий-8 , предназначенной для имплантации больших доз (6,25 1015 ион/см2) ионов массой до 200 а. е. м и током 2.. .5 мА при энергии ионов до 100 кэВ в производстве ИС на подложках диаметром 75, 100 и 150 мм. Основные элементы установки: ионный источник 1, электромагнитный масс-сепаратор 2, устройство магнитного сканирования 3, система ускорения 5, приемная камера 10. Ионный источник 1 предназначен для получения легирующих ионов В+, Р+, As+, Zn+ и Sb+. По принципу действия является дуговым с прямоканальным катодом. Дуговой разряд возбуждается в магнитном поле напряженностью Н=15 кА/м (1200 Э), что необходимо для повышения эффективности ионизации газов и паров рабочих веществ. Извлечение ионного пучка осуществляется при помощи трехэлектродной щелевой оптики. Ионный пучок, вышедший из источника ионов, ускоряется и поступает в устройство, чувствительное к массе ионов, - масс-сепаратор. Оно необходимо для удаления многозарядных ионов и ионов нежелательных примесей. Масс-сепаратор 2 представляет собой электромагнит секторного типа с углом поворота пучка 110°, радиусом равновесной траектории 300 мм и межполюоным зазором 50 мм. Наибольшая на- пряженность магнитного поля на равновесной траектории составляет 100 кА/м (8000 Э), что позволяет разделять пучки ионов в диапазоне масс 1....200 а. е. м. на промежуточной энергии ионов 15 кэВ. Питание обмоток электромагнита осуществляется от стабилизированного источника питания. В магнит-ном поле устройства сканирования 3 ионный пучок отклоняется на определенный угол. Поскольку отклонять необходимо пучок ионов, одинаково заряженных и имеющих одинаковое значение импульсов, то угол отклонения будет зависеть только от напряженности магнитного поля и его протяженности вдоль траектории ионов. Форма, размеры полюсных наконечников и межполюсного зазора обеспечивают однородность магнитного поля во всей области его действия на ионный пучок. Система ускорения 5 выполнена в виде однозазорного промежутка, образуемого двумя изолированными друг от друга щелевыми электродами. Первый электрод находится под потенциалом земли и представляет собой вогнутую диафрагму, проходное сечение которой можно изменять в зависимости от геометрии сечения пучка. На второй электрод подается ускоряющее напряжение, он имеет прямоугольную форму с вогнутой входной гранью. В приемной камере 10 размещен контейнер 11 в виде барабана, на котором устанавливаются подложки 8. Они располагаются в сменных кассетах: 100 подложек 075 или 54 подложки 0100, или 24 подложки 0150 мм. Для подготовки подложек к имплантации используются нагреватели 12. В процессе легирования барабан непрерывно и равномерно вращается с помощью привода 13 с частотой 20 мин-1. Этим обеспечивается механическое сканирование подложек в горизонтальной относительно пучка ионов плоскости. Измерение дозы и контроль равномерности легирования осуществляется универсальными дозиметрами 9. Для настройки ионной оптики служит подвижный цилиндр Фарадея 4. Вакуумная система установки выполнена на базе высоковакуумного паромасляного агрегата АВП-250/630 и обеспечивает требуемое разрежение в зоне источника ионов, зоне пролета ионного пучка и в приемной камере. Для улучшения вакуумных условий в приемной камере применяется заливная азотная ловушка 6. Вакуумный объем приемной камеры отделен от других объемов плоским затвором 7 шиберного типа с проходным сечением 120Х Х400 мм. Установки ионной имплантации, предназначенные для легирования больших и малых доз ионами высоких и низких энергий, групповым или индивидуальным методом, отличаются взаимным расположением функциональных элементов (рис. 5.2). Так, наиболее распространенным типом являются установки с системой ускорения 5, расположенной после масс-сепаратора 3 (рис. 5.2,а), т. е. осуществляющие ускорение уже отсепарированного, изотопно чистого ионного пучка. Сепарация относительно низкоэнергетичес-  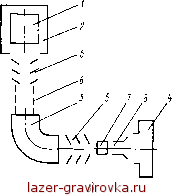 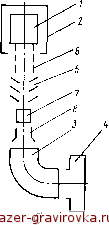 Рис. 5.2. Структурные варианты установок нонной имплантации кого ионного пучка позволяет значительно снизить габариты и мощность магнитной системы. Такая компоновка позволяет получать пучки с энергией ионов 100.. .200 кэВ. В установках ионной имплантации второй группы (рис. 5.2,6) система ускорения расположена между источником ионов и масс-сепаратором. Поскольку в этом случае производится сепарация ионного пучка уже ускоренного до энергии внедрения, то такой тип установок используется, как правило, для работы с энергиями ионов до 100 кэВ. К третьей группе (рис. 5.2,в) можно отнести установки с комбинированным ускорением как несепарированного, так и сепарированного ионного пучка. В этом случае используются два ускорителя, расположенные после источника ионов и перед приемной камерой 4. Это позволяет получать пучок с высокой энергией ионов за счет его предварительного ускорения до энергии 100 кэВ перед сепарацией и последующего ускорения до заданной максимальной энергии, которая может достичь 1 мэВ и более. Источник ионов 1, как правило, помещается в высоковольтный модуль 2. Большинство установок ионной имплантации снабжены фокусирующими системами 6, которые позволяют существенно снизить потери мощности, повысить плотность ионного тока и использовать тонкосфокусированные ионные пучки. Существуют установки ионной имплантации, различающиеся по способам сканирования ионного пучка по подложке. Применяется механическое перемещение подложек относительно неподвижного ионного пучка. В этом случае отпадает необходимость в системах магнитного или электростатического сканирования ионного пучка. По такому принципу построены, как правило, высокоэнергетические установки. Сильноточные установки предпочтительнее создавать с комбинированным сканированием: электростатическим ионного пучка с одновременным перемещением подложек. Для достижения хорошей воспроизводимости параметров имплантированных слоев от подложки к подложке и от партии к партии подложек при высокой плотности ионного тока используется индивидуальный метод обработки неподвижной пластины. При этом сфокусированный ионный пучок сканирует по всей поверхности подложки, а к системе электростатического сканирования предъявляются повышенные требования с точки зрения стабильности формы пучка и траектории его перемещения. Как видно из рис. 5.2, системы сканирования 7 и 8 могут располагаться как непосредственно перед приемной камерой 4 (рис. 5.2,а, в), так и перед масс-сепаратором 3 (рис. 5.2,6). Первый вариант является более предпочтительным, так как сканированию подвергается рабочий, изотопно чистый пучок в непосредственной близости от подложки. В установках ионной имплантации применяются источники ионов, различающиеся по принципу образования одно- и многозарядных ионов. Последние используются в высокоэнергетических системах. Существуют источники образования ионов электронным или ионным ударом, в результате термического воздействия или химической реакции, дуговым разрядом в парах рабочего вещества или лазерным излучением, а также газоразрядные, плазменные и высокочастотные источники ионов. Назначением каждого источника является эффективное сообщение нейтральным атомам и молекулам вещества количества энергии, достаточного для отрыва внешних электронов. В результате ионизации в источнике устанавливается определенная концентрация заряженных частиц, вытягивание которых и формирование в пучок требуемого сечения является назначением ионно-оптической системы. Извлеченный из ионного источника, пучок последующей магнитной сепарацией приводится в моноизотопное состояние определенного химического элемента с током от десятков до тысяч микроампер. В установках ионной имплантации применяются масс-сепараторы на постоянных магнитах, с ортогональными маг- нитными и электрическими полями, с одновременным воздействием постоянного и переменного электрических полей. Сепарация ионного пучка основана на взаимодействии движущихся ионов с магнитными и электрическими полями под действием силы Лоренца и производится, как правило, на промежуточной энергии до 25 кэВ. Масс-сепаратор является элементом, от которого в основном зависят габариты установки ионной имплантации. Уменьшение его размеров можно осуществить за счет сокращения зазора между полюсными наконечниками и угла поворота пучка. Системы ускорения ионного пучка бывают двух типов: с одиночным зазором между двумя электродами (используются для сообщения ионам энергии до 40. ..100 кэВ) и с многозазорными ускорительными секциями, на каждой из которых ионы получают энергию по 15.. .20 кэВ (используются в установках с высокими, до 1 МэВ и более энергиями ионов). Фокусировку пучка до определенного сечения можно осуществить как электростатическим, так и магнитным полем. Фокусирующие линзы могут быть в виде полых цилиндров, диафрагм с отверстиями или электромагнитных катушек. Применяемые в установках ионной имплантации устройства сканирования пучка используются для центрирования движения пучка в ионно-оптической системе, направления пучка на определенный участок, сканирования пучка по подложке. При этом не должна нарушаться фокусировка пучка, система отклонения должна иметь достаточную чувствительность и малую инерционность. Одним из главных преимуществ процесса ионной имплантации является возможность точного контроля дозы внедряемой примеси. При этом измеряется как общее количество ионов, попадающих на мишень, так и равномерность их распределения по поверхности пластины. Основным методом определения дозы в промышленном оборудовании является измерение тока пучка с помощью цилиндра Фарадея. Вакуумные системы установок ионной имплантации предназначены для создания требуемого разрежения в источнике ионов, ионопроводах и приемной камере. Использование масляных средств откачки может привести к разложению тяжелых углеводородов под действием электронной и ионной бомбардировки и осаждению их в виде сажи на подложке. Необходима защита от проникновения паров масла в объем приемной камеры. Более эффективны безмасляные средства откачки. На рис. 5.3 показана вакуумная схема установки ионной имплантации, выполненная на базе турбомолекулярных насосов (ТМН). Приемная камера 3, источник ионов 1 и ионопровод 2 откачиваются до давления 6,5-Ю-4 Па, в шлюзовой камере 4 создается разрежение 1,3-Ю-1 Па. Высоковакуумная откачка производится с помощью двух турбомолекулярных насосов NR1 и NR2, форвакуумная от- |
|
© 2026 ООО "Стрим-Лазер": Лазерная гравировка.
Все права нотариально заверены. Копирование запрещено. |