 |
(495)510-98-15
|
|
Меню
|
Главная » Промышленная электроника 1 2 3 4 5 6 7 8 [ 9 ] 10 11 12 13 14 15 16 17 18 19 20 21 22 23 24 25 26 27 28 29 30 31 32 33 34 35 36 37 38 39 40 41 42 43 44 45 46 47 48 49 50 51 52 53 54 55 56 57 58 59 60 61 62 63 64 65 66 67 68 69 70 71 72 73 74 75 76 77 78 79 80 81 82 83 84 85 86 87 88 89 90 91 92 93 94 95 96 97 98 99 100 101 102 103 104 105 106 107 108 109 110 111 112 113 114 115 116 117 118 119 120 121 122 123 124 125 126 127 128 129 130 131 132 133 134 135 136 137 138 139 140 141 142 143 144 145 146 147 148 149 150 151 152 153 154 155 156 157 158 159 160 161 162 163 164 165 166 етСя электрически нейтральным. Эти электроны увеличивают °СТ центранию основных носителей заряда в примыкающем к р-п-пере-к0 v базовом слое (на рис. 1.9, в не показано). Ее распределение Х°оль оси х соответствует распределению вдоль этой оси концентрации Веоавновесных дырок, вызванной их диффузией через р-п-переход. Н Непрерывные диффузия дырок через p-n-переход и их рекомбинация с электронами в прилегающем слое базы создают непрерывный приток электронов от отрицательного полюса источника, а следовательно, и ток в рассматриваемом участке цепи. Таким образом, в то время как прямой ток в p-n-переходе определяется диффузионным током дырок, ток в основной части базового слоя и внешнем выводе обусловливается дрейфовым током электронов. В примыкающем к p-n-переходу базовом слое прямой ток равен сумме диффузионного тока дырок и дрейфового тока электронов. Уменьшение дырочной диффузионной составляющей тока по мере удаления от границы p-n-перехода объясняется уменьшением градиента концентрации дырок вследствие их рекомбинации с электронами. Описанное явление обычно наблюдается при относительно большой ширине п-слоя в так называемых диодах с толстой базой. В диодах с тонкой базой, когда ее толщина соизмерима с диффузионной длиной дырок Lp (рис. 1.9, б), большинство дырок успевает в результате диффузии пройти базу без рекомбинации, в связи с чем ток в базе будет преимущественно определяться диффузионным током дырок. Подобные процессы наблюдаются и в слое эмиттера. Избыточная концентрация электронов, созданная в прилегающей к р-п-переходу области под действием диффузии, компенсируется повышением там концентрации дырок (на рис. 1.9, в не показано). Однако для несимметричного p-n-перехода роль электронной составляющей диффузионного тока в общем токе, протекающем через переход, мала. Ее роль несущественна и в токе, протекающем через эмиттерный слой. Ток через эмиттерный слой обусловливается в основном дрейфовым током дырок ввиду существующей в этом слое напряженности электрического поля от внешнего источника. Обратная ветвь вольт-амперной характеристики диода При подключении к диоду источника внешнего напряжения в обратном направлении (рис. 1.10, а) потенциальный барьер возрастает на величину Uъ и становится равным ф0 + U ъ (Рис. 1.Ю, б). При этом увеличиваются объемный заряд в р-п-пере-Ходе и его ширина. Возросший потенциальный барьер затрудняет прохождение через p-n-пер.еход основных носителей заряда, вследствие чего диффузионный ток, создаваемый этими носителями, умещается. Дрейфовый же ток, обусловленный концентрациями неос-овных носителей заряда по обе стороны перехода (/др = 7др р + он дрп), можно считать неизменным (рис. 1.10, б). Однако теперь будет превышать диффузионный ток. Через диод будет протекать в обратном направлении: J b др J a. (1.141 Обратная ветвь вольт-амперной характеристики диод показана на рис. 1.10, г. При небольших обратных напряжения? (участок 0-1) увеличение обратного тока наблюдаете за счет уменьшения диффузионной составляющей. При обратно?, напряжении, соответствующем точке 1 и большем, основные носи тели заряда не способны преодолеть потенциальный барьер, в связи с чем диффузионный ток равен нулю! Этим объясняется отсутствие роста об} ратного тока при увеличении обратного напряжения (участок характеристика левее точки 1). Приведенная на рис. 1.10,6 диа| грамма распределения концентрации соответствует обратным напряжениям! превышающим напряжение в точке 1ц Она подтверждает неизменность обрат ного тока на рассматриваемом участке! В отсутствие инжекции распреде! ленче концентраций носителей заряд! в прилегающих к p-n-переходу слоя/ характеризуется уменьшением концент раций неосновных носителей велел ствие их ухода через p-n-переход. Н| границах р-га-перехода для неосновные носителей заряда действует ускоряя щее поле р-га-перехода, вследствие чег! их концентрация там равна нулю. По скольку в прилегающих к р-га-перехо ду слоях полупроводник должен ос таьаться электрически нейтральным уменьшение в них концентрации не основных носителей заряда вызывае' аналогичное уменьшение концентрации основных носителей заряда. Однакй ввиду существенно большей концент! рации основных носителей заряда эт< снижение слабо отражается на их знг чениях (на рис. 1.10, в не показано) Составляющие дрейфового тока (JnvP и J Лрп) создаются неос[ новными носителями заряда (дырками и электронами), диффунди! рующими к границам р-л-перехода из прилегающих к ним слоев! Они определяются по градиентам концентрации неосновных носи! телей заряда на границах р-л-перехода, т. е. из условия их диффу! зии в направлении перехода, и не зависят от приложенного напря жени я U ъ. Обратный ток., создаваемый неосновными носителями заряда,! зависит от их конденсаций в р. и и-слоях, а также от рабочей поТ 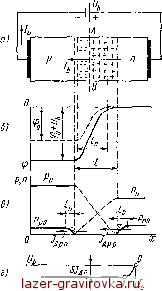 Рис. МО. Полупроводниковый диод при подключении внешнего напряжения в обратном направлении: э - схема включения; б - потенциальный барьер при обратном напряжении; s - распределение концентраций носителей заряда; г - обратная ветвь вольт-амперной характеристики верхности р-л-перехода. Этим объясняется тот факт, что в мощных плодах- имеющих большую площадь р-п-перехода, обратный ток больше, чем в маломощных. Поскольку концентрация неосновных носителей заряда является функцией температуры кристалла, обратный ток диода также зависит от температуры. По этой причине обратный ток иногда называют тепловым. Увеличение обратного тока с ростом температуры подчиняется примерно экспоненциальному закону. Как известно, концентрация неосновных носителей заряда уменьшается с ростом ширины запрещенной зоны на энергетической диаграмме полупроводника. Ширина запрещенной зоны в кремнии (1,12 эВ) больше, чем в германии (0,72 эВ). В силу этого обратный ток в кремниевых диодах на несколько порядков меньше, чем в германиевых, и кремниевые диоды допускают эксплуатацию при более высокой температуре полупроводниковой структуры (135-]40°С про тив 50-60°С у германиевых диодов). Кроме того, кремниевые диоды применимы при более высоких обратных напряжениях, чем герма--ниевые (2о00-3500 В против наибольших значений 500-600 В у германиевых диодов). Полная вольт-амперная характеристика диода Полная вольт-амперная характеристика полупроводникового диода приведена на рис. 1.11. От характеристики идеального диода (см. рис. 1.7, б) она отличается наличием некоторого падения напряжения на приборе при пропускании прямого тока и обратного тока в случае приложения обратного напряжения. Как известно, прямой ток диода создается основными, а обратный - неосновными носителями заряда. Концентрация основных носителей заряда на несколько порядков превышает концентрацию неосновных носителей. Этим и обусловливаются вентильные свойства р-п-перехода, а следовательно, и диода. Проведенному теоретическому анализу Рис и и. вольт-амперной характеристики диода со- р0Ванная вольт-ам-°тветствует ее запись в аналитической фор- перная характеристи-ме:
ка диода (1.15) Де / s = sjap - ток насыщения (тепловой ток), создаваемый неос-(вными носителями заряда; срг-тепловой потенциал. д При U - о согласно соотношению (1.15) /а = 0. В случае при-Жения прямого напряжения (U = £/а> 0) в (1.15) единицей можно Небречь и зависимость /а(с/а) будет иметь экспоненциальный |
|
© 2026 ООО "Стрим-Лазер": Лазерная гравировка.
Все права нотариально заверены. Копирование запрещено. |